
在半導(dǎo)體制造中,晶圓切割是決定芯片良率的關(guān)鍵一步。面對(duì)切割道檢測(cè)中的重重挑戰(zhàn),如何實(shí)現(xiàn)精準(zhǔn)定位與高效檢測(cè)?本文將深入解析高低雙倍率視覺系統(tǒng)的創(chuàng)新解決方案,助您攻克技術(shù)難點(diǎn),切實(shí)提升生產(chǎn)效能。
01
什么是劃片?
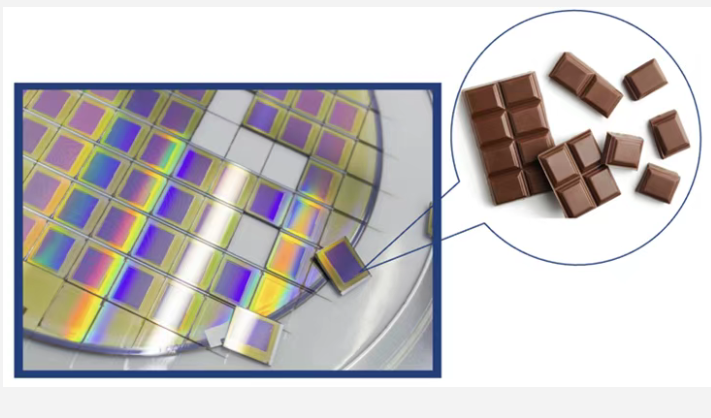
Wafer dicing(晶圓切割)是半導(dǎo)體制造流程中的一個(gè)關(guān)鍵步驟,指的是將一個(gè)完成芯片制造的整片晶圓(wafer)切割成一個(gè)個(gè)單獨(dú)的芯片(die)的過程。這一步通常是在晶圓上的所有電路圖形都制作完成、并且通過了測(cè)試之后進(jìn)行。切割方法以自動(dòng)化執(zhí)行來保證精度與準(zhǔn)確性,切割后的單個(gè)裸晶用于后續(xù)工序,最后構(gòu)建在電子設(shè)備中。
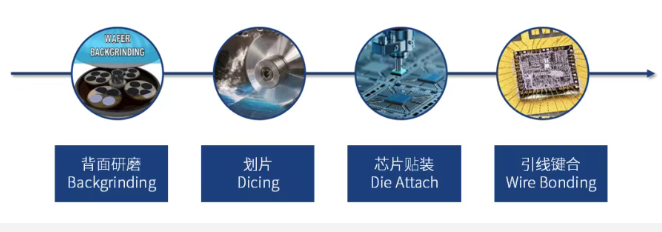
首先,標(biāo)準(zhǔn)半導(dǎo)體制造采用“減薄后切割”方法。晶圓在切割前會(huì)被稱為背面研磨(back side grinding)的工藝打薄到幾十μm的厚度,貼在專用的Dicing Tape上并固定在切割環(huán)(Frame)上從而降低了在后續(xù)的過程中的機(jī)械應(yīng)力導(dǎo)致晶圓破裂的風(fēng)險(xiǎn)。在切割后使用自動(dòng)pick-and-place系統(tǒng)將die拾取封裝,安裝在各種電子設(shè)備中發(fā)揮它的作用。
02
機(jī)器視覺任務(wù)
為確保切割精度、保護(hù)良品率、提升自動(dòng)化水平;用于避免偏切、誤切、切到有效芯片區(qū)域,在Dicing工藝中機(jī)器視覺的關(guān)鍵任務(wù)為:
1.自動(dòng)識(shí)別晶圓上切割道或網(wǎng)格線的位置;
2.有時(shí)還需根據(jù)Die的標(biāo)記(如晶圓ID、對(duì)準(zhǔn)標(biāo)記、圖案對(duì)稱性)確定旋轉(zhuǎn)角度和坐標(biāo)原點(diǎn)。
而在此過程中,需要獲取清晰明暗對(duì)比強(qiáng)烈的工件表面、鐳射痕跡與刀痕圖像。由兩套固定倍率的鏡頭組成的視覺系統(tǒng)進(jìn)行切換。低倍與高倍系統(tǒng)在工作中“先看全局、再看細(xì)節(jié)”,每種倍率在流程中承擔(dān)明確分工。

03
對(duì)鏡頭與光源的挑戰(zhàn)

1.防水霧與飛濺:切割過程中有高壓去離子水冷卻與微粒飛濺,伴隨霧化液滴極易污染鏡頭與光源,要求從結(jié)構(gòu)上光源與鏡頭具備防護(hù)設(shè)計(jì);
2. 結(jié)構(gòu)緊湊:刀頭周邊空間緊湊,需在刀頭、吸嘴、吹氣嘴間集成視覺模塊;
3. 鏡頭成像一致性高:定位精度需達(dá)到微米級(jí),倍率切換,單支鏡頭與批量多支鏡頭差異不能影響圖像測(cè)量精度;
4. 低角度分區(qū)照明環(huán)光:切割道往往反差不明顯,需強(qiáng)化邊緣對(duì)比且避免反光干擾。
04
解決方案
使用 REL07519C/REL7519C 鏡頭搭配 RELW40 環(huán)形光源,可在 Dicing 應(yīng)用中有效應(yīng)對(duì)關(guān)鍵成像挑戰(zhàn),優(yōu)勢(shì)如下:

05
關(guān)鍵參數(shù)
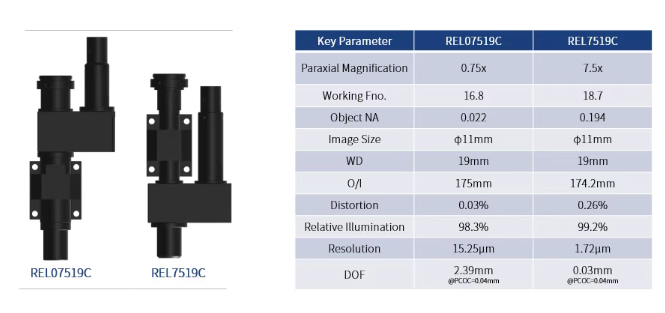
康耐視工業(yè)相機(jī),康耐視讀碼器,康耐視掃碼器報(bào)價(jià)請(qǐng)從Cognex資深經(jīng)銷商艾韋迅獲取康耐視價(jià)格清單。同時(shí)提供康耐視讀碼器售后維修服務(wù),歡迎咨詢18924129201